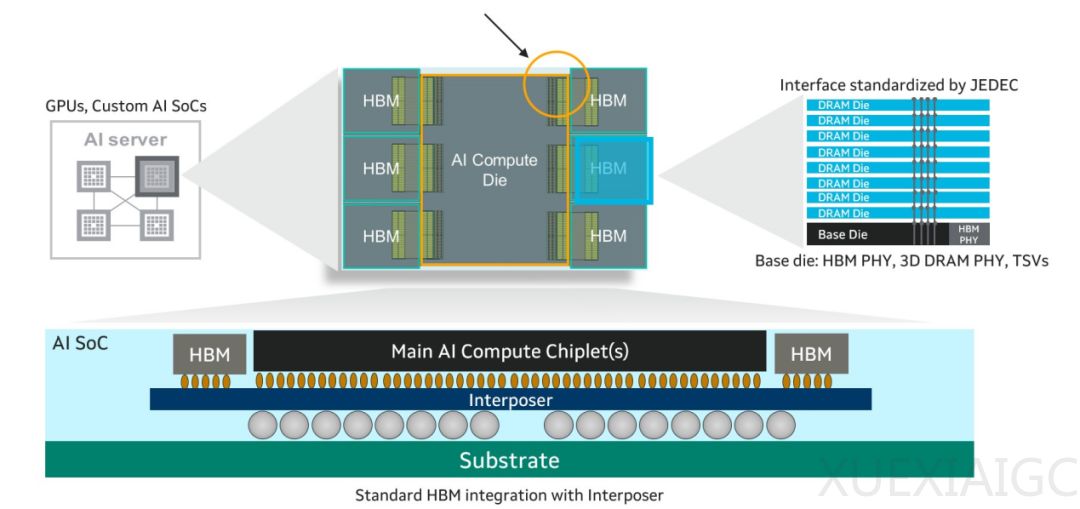
文章摘要
在AI模型参数量呈指数级增长的时代背景下,数据中心正经历一场从“算力至上”向“带宽驱动”的深刻变革。HBM(高带宽存储器)作为支撑大模型计算的核心基础设施,逐渐成为半导体巨头竞争的战略制高点。三星、SK海力士和美光等存储领域的领军企业纷纷将HBM视为未来营收增长的关键引擎,并围绕定制化和混合键合技术展开激烈角逐。
定制化HBM已成为行业趋势。随着云巨头纷纷定制自己的AI芯片,对HBM的需求持续增长,定制化成为必然选择。SK海力士已与英伟达、微软、博通等重量级客户达成协议,供应定制型HBM,并计划从第七代HBM(HBM4E)开始全面转向定制化。三星电子也在积极与AMD、博通等客户协商定制HBM的供应。定制化HBM的关键在于将基础芯片功能集成进逻辑芯片中,赋予SoC设计人员更大的灵活性,优化功耗、性能与面积(PPA)。然而,定制HBM仍面临技术挑战,如芯片生命周期管理和测试问题,需要完整的生态系统支持。
混合键合技术是HBM未来发展的重要方向。随着堆叠层数增加,传统焊接技术面临挑战,混合键合通过铜与铜的直接连接,显著缩小芯片尺寸并提升能效与性能。三星和SK海力士正推进混合键合技术用于下一代HBM产品,预计将在HBM4和HBM4E中率先引入。混合键合技术的应用将引发半导体设备领域的重大洗牌,相关厂商如应用材料公司、韩美半导体和韩华半导体正在加速研发相关设备。
HBM技术的演进路径清晰,未来将实现量级跃升。从HBM4到HBM8,带宽将从2.0 TB/s增长至64 TB/s,容量从48 GB提升至240 GB。3D集成技术、TSV技术和中介层技术的持续突破为HBM性能提升提供了硬件保障。散热技术也从传统风冷逐步升级为嵌入式冷却技术,解决了高性能HBM的散热瓶颈。HBM技术的演进不仅满足了当前AI应用的需求,还为未来的人工通用智能(AGI)奠定了技术基础。
在这场高度复杂的技术竞赛中,系统级视野和跨界整合能力将成为制胜关键。随着SK海力士将基础裸片代工交由台积电,DRAM厂商在HBM制造流程中的主导能力逐步减弱,HBM技术体系已不再是单一厂商可以独自完成的任务。未来,HBM的竞争将愈演愈烈,唯有具备深度整合多维工艺与生态资源的玩家,才有机会脱颖而出。
原文和模型
【原文链接】 阅读原文 [ 5367字 | 22分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 deepseek-v3
【摘要评分】 ★★★★★





