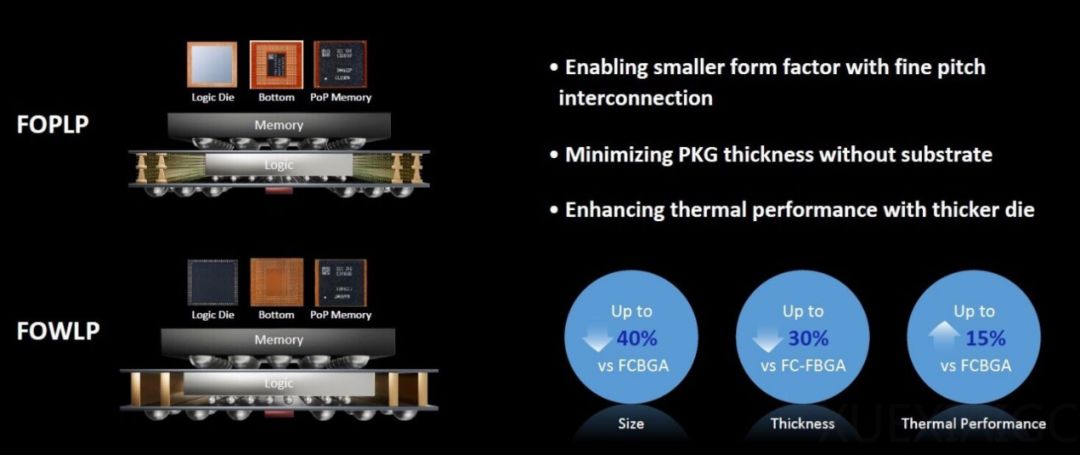
文章摘要
【关 键 词】 台积电、封装技术、AI芯片、FOPLP、玻璃基板
台积电在2011年宣布进军封装领域,推出了CoWoS技术,该技术通过将逻辑芯片和DRAM放置在硅中介层上,再封装在基板上,为AI芯片的发展提供了重要支持。CoWoS技术的成功应用在英伟达的GP100图形芯片和谷歌AlphaGo的TPU 2.0中,标志着先进封装技术在半导体行业中的重要性日益凸显。
随着AI芯片需求的增长,台积电面临CoWoS产能不足的问题,因此开始探索更多封装技术,如FOPLP(扇出型面板级封装)。FOPLP技术相较于FOWLP(扇出型晶圆级封装)具有更低的单位成本和更大的封装尺寸,能够提高封装效率并降低成本。Yole Group预计,FOPLP市场将以32.5%的复合年增长率增长,到2028年市场规模将达到2.21亿美元。
台积电在FOPLP技术上的布局包括成立研发团队和产线,预计三年后技术成熟并具备量产能力。此外,力成和群创等台湾封测企业也在加速开发FOPLP,力成已建立全球首座FOPLP生产线,群创则利用现有设备转型,预计今年第四季度正式量产。
FOPLP技术的发展也推动了玻璃基板的需求,因为传统的塑料基板在大尺寸封装中容易出现翘曲问题。玻璃基板提供了更光滑的表面和更高的互连密度,同时在热学性能和物理稳定性方面表现更优。然而,玻璃基板的易碎性和缺乏统一标准仍是需要克服的挑战。
英特尔和三星在玻璃基板技术上的进展显著,英特尔计划在2026年至2030年推出用于先进封装的玻璃基板,而三星也在积极研发并计划在2026年实现量产。台积电虽然未明确提及玻璃基板技术,但据传已有相关技术储备,并可能重启研发以满足客户需求。
随着FOPLP和玻璃基板技术的成熟,封装行业可能会向面板级封装发展,这将为封装行业带来新的机遇和挑战。在这个过程中,能够快速适应并采用新技术的厂商将有机会获得更多的市场份额。
原文和模型
【原文链接】 阅读原文 [ 4147字 | 17分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 moonshot-v1-32k
【摘要评分】 ★★★★★



