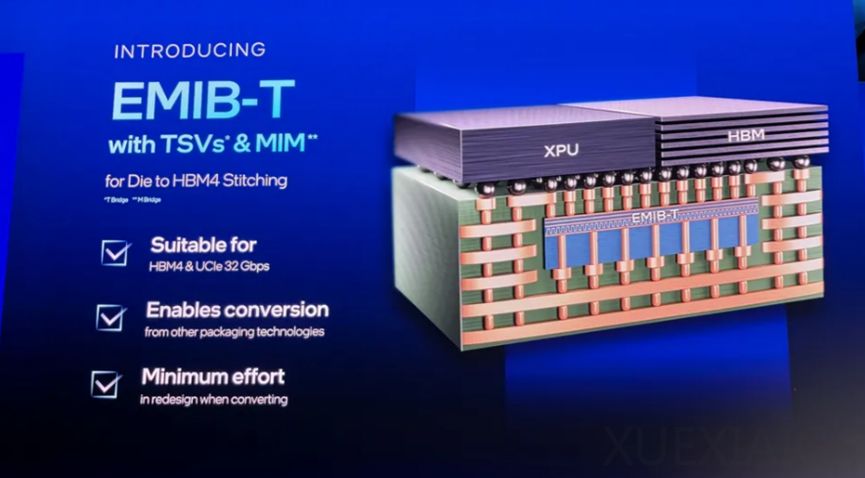
文章摘要
【关 键 词】 芯片封装、EMIB技术、散热技术、热压工艺、代工服务
英特尔在电子元件技术大会上披露多项芯片封装技术突破,旨在利用尖端工艺节点技术为内外部公司生产芯片,以应对现代处理器复杂异构设计对先进封装技术的需求,保持与竞争对手同步。
EMIB – T技术优势显著:它将硅通孔融入广泛使用的EMIB技术,提升了封装供电效率,解决了标准EMIB连接的高电压降问题,实现直接、低电阻供电路径,对HBM4/4e集成至关重要。同时,提升了芯片间通信带宽,能集成高速HBM4/4e内存封装,使用UCIe – A互连技术使数据传输速率达32 Gb/s或更高。还能实现更大芯片封装尺寸,支持更多桥接器和裸片,缩小凸块间距,且兼容有机或玻璃基板,玻璃基板是未来关键战略方向。
全新分解式散热器技术:将散热器分解成平板和加强筋,改善了散热器与热界面材料的耦合,有助于减少TIM耦合焊料中的空隙。集成微通道的散热器可冷却TDP高达1000W的处理器封装,从多角度解决芯片冷却问题。
新型热压粘合工艺:针对大型封装基板开发,能最大限度减少键合过程中封装基板和芯片之间的热差,提高良率和可靠性,实现更大芯片封装和更精细的EMIB连接间距。
完善且有竞争力的封装技术对英特尔代工厂意义重大,可让客户将不同供应商的芯片集成到单个封装中,降低过渡到英特尔工艺节点的风险。英特尔还为不使用其制造组件的芯片提供封装服务,有助于拓展客户关系。目前已有AWS、思科等行业巨头及美国政府项目成为其封装服务客户,封装合同是英特尔代工厂创收的最快途径。
原文和模型
【原文链接】 阅读原文 [ 1542字 | 7分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 doubao-1.5-pro-32k
【摘要评分】 ★★★☆☆
© 版权声明
文章版权归作者所有,未经允许请勿转载。
相关文章
暂无评论...





