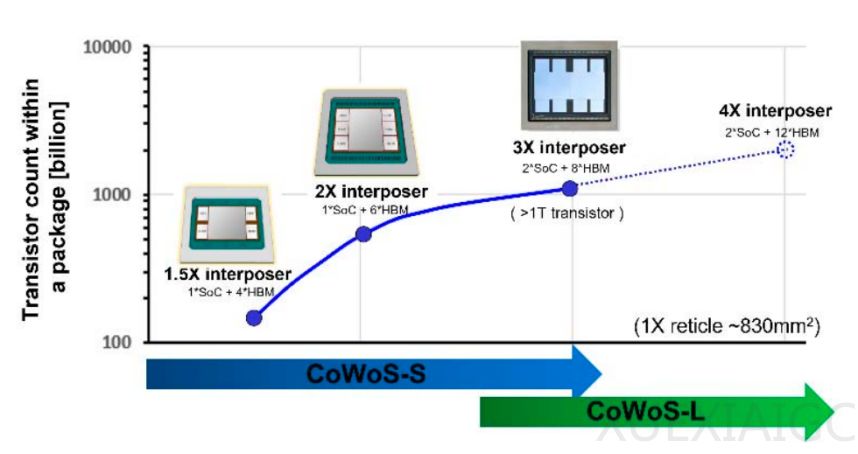
文章摘要
【关 键 词】 CoWoS-L、封装技术、高性能计算、半导体需求、3D芯片堆叠
台积电在ISSCC 2023上展示了其新技术CoWoS-L,这是英伟达最新GPU采用的关键技术。CoWoS-L是一种2.5D系统级封装解决方案,通过重组插层层(RI)解决了大型硅中介层导致的良率损失问题。RI包含多个本地硅互连(LSI)芯片和全局再分布层(RDL),取代了CoWoS-S中的单片硅中介层。LSI芯片继承了硅中介层的特性,如亚微米级铜互连、硅通孔(TSV)和嵌入式深沟电容器(eDTC),同时避免了大型硅中介层的问题。CoWoS-L采用3倍光罩尺寸的插接器,搭载多个SoC/芯片模组和8个HBM,已成功演示电气特性和元件级可靠性,表明CoWoS-L架构将满足未来高性能计算和人工智能深度学习的需求。
CoWoS-L封装由top die、重组插层和基板组成,通过细间距微凸块并排粘合在中介层上。CoWoS-L是一种“chip last”组装,即在top die堆叠之前进行interposer制造。CoWoS-L提供两种LSI芯片:LSI-1和LSI-2,主要区别在于互连金属方案。CoWoS-L可提供比CoWoS-S更高的电容,通过连接所有LSI芯片的电容,显著提高RI上eDTC的总电容。
在电气性能和可靠性测试方面,CoWoS-L展现了出色的SI和PI性能。CoWoS-L封装的电气测量结果表明其具有出色的电气性能和完美的集成方案。CoWoS-L的元件级可靠性测试遵循JEDEC标准,包括湿度敏感级(MSL4)测试、热循环测试(TCG)、无偏高度加速应力测试(u-HAST)和高温存储测试(HTS)。测试结果表明,CoWoS-L结构具有稳健性和可制造性。
半导体行业是数字经济的基础,推动了人工智能、高性能计算、无线连接和自动驾驶等领域的创新。市场预期显示,HPC、智能手机、汽车和物联网(IoT)是半导体需求的主要来源。半导体技术的进步,如光刻技术、器件架构、新材料、集成方案和新功能,将继续推动产品在功率、性能和面积(PPA)方面的缩小。DTCO和STCO在提高SRAM性能方面发挥了关键作用。3D芯片堆叠技术提高了带宽和功耗,已应用于HPC产品。
在HPC和AI领域,特定领域的工艺优化可以进一步改善计算平台。先进的封装和集成对于实现系统级性能也变得越来越重要。CoWoS、InFO和SoIC等集成方案可以在封装系统中集成超过5000亿个晶体管。3D SoIC和CoWoS技术使类似AMD的AI加速器产品MI300X成为可能。提高3D芯片间互连密度对于未来的系统扩展和性能至关重要。电力输送技术已经得到开发,以实现芯片和封装内的有效分配。CPO有望提供超过224Gb/s的更高带宽密度和能效。
在移动领域,无线连接已成为移动设备和大多数物联网设备的标准功能。能源效率仍然是移动应用程序技术优化的首要要求。移动SoC不断发展,以实现更快的链接速度、更低的延迟和更好的能源效率。6G有望在更广泛的使用条件下以更好的能效、更快、更稳定的数据速度进一步扩展应用。
汽车行业正在经历根本性的转变,这些转变是由许多底层半导体技术推动的,包括强大的处理器、更先进的微控制器(MCU)和一类新的功率器件。
原文和模型
【原文链接】 阅读原文 [ 7715字 | 31分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 moonshot-v1-32k
【摘要评分】 ★★★★★



