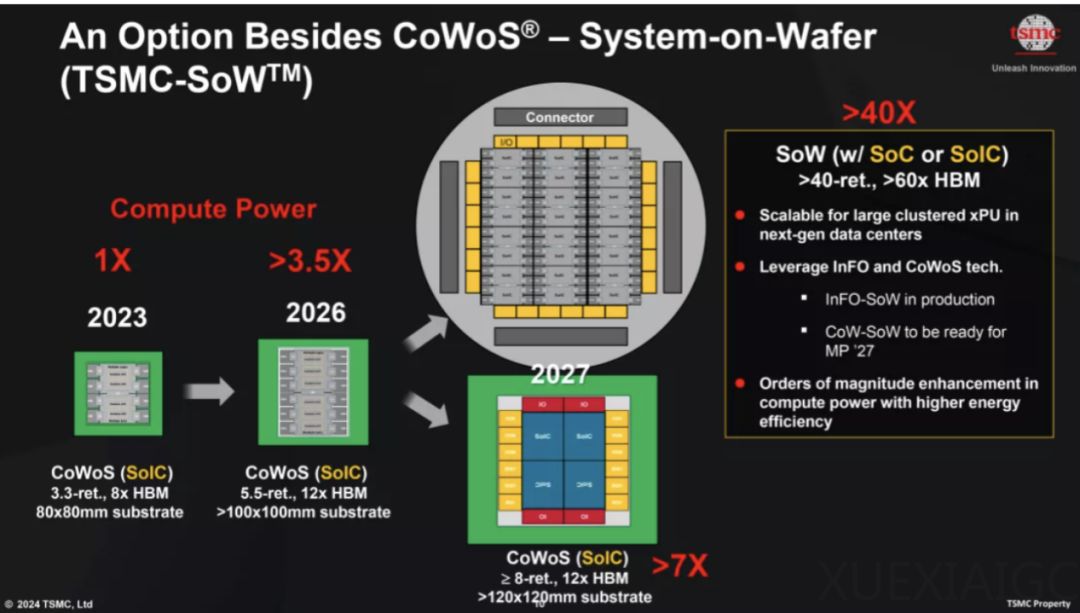
文章摘要
【关 键 词】 封装技术、AI芯片、产能扩张、3D IC、硅光子
台积电正积极扩展其先进封装产能以满足AI服务器需求的增长。公司董事长魏哲家在财报会议上透露,由于人工智能的快速发展,CoWoS技术需求强劲,公司正努力在2025-2026年达到供需平衡。台积电通过购买群创南科4厂(AP8厂区)来加速封装产能的扩张,预计该厂产能将是现有竹南厂的9倍,并计划于2025年下半年投产。此外,台积电还在嘉义科学园区建设CoWoS先进封装厂,尽管施工过程中遇到了考古遗址的问题,但预计不会影响2023年第三季度的装机计划。
台积电的封装技术正在不断升级。公司在北美客户研讨会上展示了其芯片封装和尖端光学互连技术的路线图。CoWoS技术将支持更大的中介层尺寸,预计到2027年将达到8倍光罩尺寸。3D IC技术也将从目前的9μm凸块间距缩小到2027年的3μm间距。台积电的3D堆叠集成芯片系统(SoIC)技术将允许更高性能的部件实现超密集连接。
台积电还计划推出SoIC-P封装工艺,专为需要3D堆叠但不需要高性能的应用设计。预计到2025年,公司将提供F2B凸块SoIC-P技术,而2027年将推出F2F凸块SoIC-P技术。公司对SoIC的采用持乐观态度,预计到2026-2027年将有约30种SoIC设计发布。
在3D IC领域,台积电认为这是将AI芯片存储器与逻辑芯片集成的关键方法。公司预计,到2030年,全球半导体市场将成为万亿产业,其中高性能计算(HPC)和AI将成为主要驱动力。3D IC技术可以帮助降低AI芯片的量产成本,并提高总体拥有成本(TCO)。
台积电还在探索光电封装技术,计划将光学互连集成到客户设计中。公司正在开发紧凑型通用光子引擎(COUPE)技术,以支持AI带来的数据传输需求。COUPE技术将电子芯片堆叠在光子芯片之上,提供更低的阻抗和更高的能效。台积电计划在2025年使COUPE获得小型可插拔器件的认证,并在2026年将其集成到CoWoS封装中。
台积电在硅光子技术领域也有所布局,公司参与建立了硅光联盟,以推动该技术的普及。公司副总总经理徐国晋强调,随着AI时代对大量运算和数据传输的需求,硅光子元件的导入将成为数据中心的重要趋势。
总体来看,台积电在封装技术领域的扩张和创新表明了其在满足AI和高性能计算需求方面的领先地位。通过不断的技术升级和产能扩张,台积电正努力成为封装领域的领导者。
原文和模型
【原文链接】 阅读原文 [ 3978字 | 16分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 moonshot-v1-32k
【摘要评分】 ★★★★★



