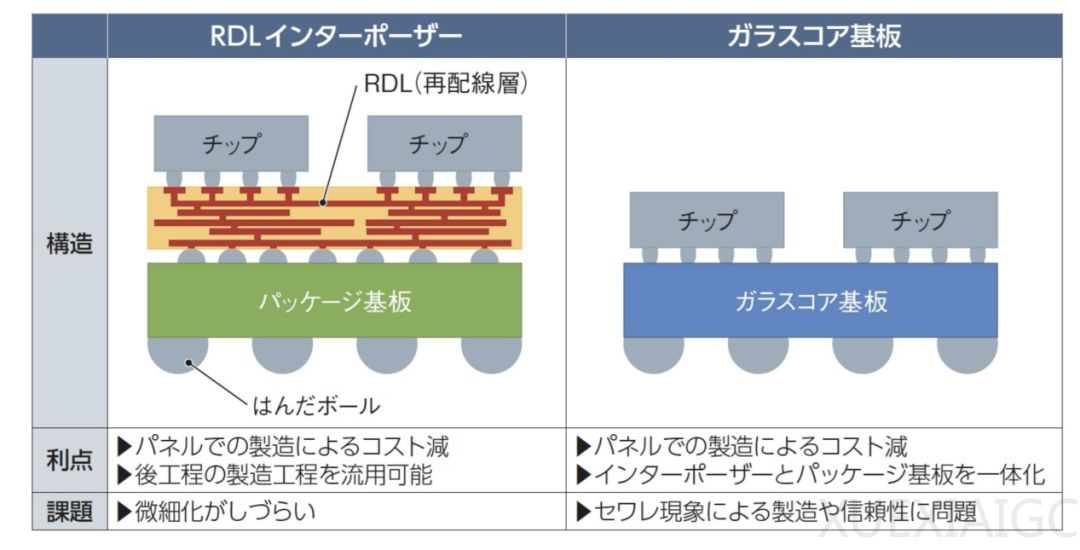
文章摘要
【关 键 词】 半导体封装、中介层替代、RDL技术、玻璃芯基板、技术创新
随着半导体封装技术的发展,行业正致力于消除对中介层(中间基板)的需求,这是2.5D封装中的关键组成部分。目前,硅中介层因其高生产率而被广泛使用,但随着封装尺寸的增大,其成本效益逐渐降低。
Yasumitsu Orii,Rapidus的高级常务执行官,预测到2027年,中介层的尺寸将达到8掩模版大小(约81毫米见方),这将使面积增加近两倍。然而,硅中介层可能难以应对这种尺寸增长,因为300mm的晶圆仅能生产约10个8掩模版尺寸的中介层,实际可生产的矩形中介层数量更少。
为了解决这一问题,面板生产的中介层应运而生。使用方形和大面板可以增加部件数量,同时减少面积浪费。Lapidus公司宣布计划使用600毫米方形面板来制造中介层。目前,面板制造的中介层主要有两种选择:有机材料和玻璃。Lapidus选择了使用有机材料的RDL中介层,这是一种由铜和绝缘层构成的布线层。
尽管RDL技术在FOWLP(扇出晶圆级封装)中已有应用,但在大型面板上制造多层RDL时,翘曲成为一个问题。此外,有机材料的布线宽度较厚,目前最新RDL的线距约为2μm,而硅中介层允许布线宽度为1μm或更小。不过,技术发展仍在不断进步,Resonac等公司正在努力实现更小线距的多层L/S。
除了有机材料,玻璃芯基板也是硅中介层的一种有前景的替代品。美国英特尔公司和韩国SK海力士公司正在努力将其商业化。英特尔计划从2020年代末开始大规模生产玻璃芯基板,并已投资超过10亿美元在美国亚利桑那州建设研发线。SK集团旗下的Absolics公司也在美国佐治亚州建成了玻璃芯基板生产线,计划于2024年开始量产。
此外,工业创新投资公司(JIC)、大日本印刷和三井化学于2023年12月宣布收购富士通子公司新光电气工业,这也是与玻璃芯基板相关的举措之一。DNP的一位高管表示,从2028年左右开始,玻璃芯基板有可能被用于半导体的大规模生产。
总之,随着半导体封装技术的发展,行业正寻求替代硅中介层的新材料,如有机材料和玻璃芯基板。尽管面临一些技术挑战,但随着研发的不断深入,这些新材料有望在未来实现更大规模的生产和应用。
原文和模型
【原文链接】 阅读原文 [ 3279字 | 14分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 moonshot-v1-32k
【摘要评分】 ★★★★★





