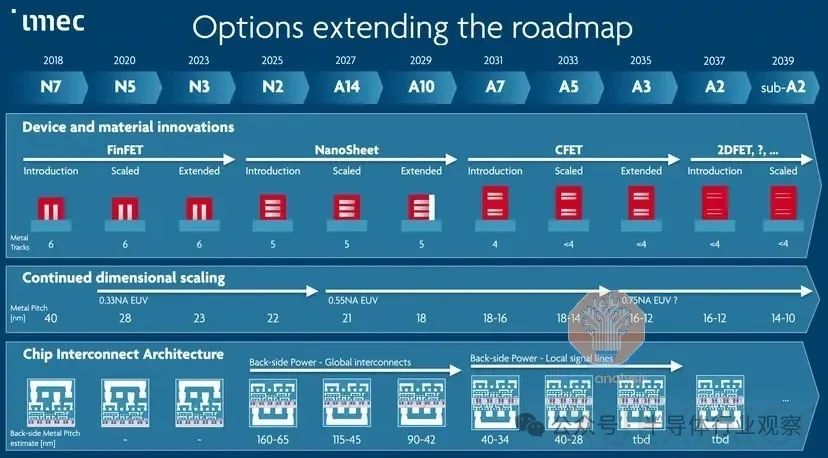
文章摘要
在SPIE先进光刻与图案技术会议上,高数值孔径(High NA)EUV光刻技术成为焦点,尤其是英特尔和ASML的合作进展。英特尔已安装了两台High NA EUV光刻机,并累计曝光了3万片晶圆,标志着其在14A节点产品战略中的关键地位。英特尔的目标是以创纪录的速度推出一条采用High NA EUV系统的开发试验线,避免Low NA EUV带来的产能爬坡缓慢问题。这一过程中,英特尔与ASML密切合作,开发了多项首创的扫描仪技术,并跳过了传统的工厂集成和测试环节,直接在英特尔进行测试。
High NA EUV技术的成功不仅依赖于扫描仪本身,还需要工艺、光罩和光学邻近校正(OPC)等技术的协同发展。英特尔通过模拟和低NA曝光相结合的方法,开发了一种无需真实晶圆数据即可校准OPC模型的新方法,显著缩短了光罩的生产时间。这一创新使得光罩几乎可以立即投入试产线,传统上这一过程需要数月时间。
在性能测试中,High NA EUV扫描仪的光源功率和可靠性均超出预期,套刻性能也达到了0.6纳米的精度,与低数值孔径工具对齐。这一结果使得英特尔和ASML宣布,High NA对缝合区域没有任何影响,尽管无晶圆厂客户是否会接受缝合芯片仍是一个悬而未决的问题。此外,英特尔还分享了金属层和接触孔层的早期器件数据,显示High NA EUV技术在良率方面与现有的低数值孔径多重曝光工艺相当。
然而,High NA EUV技术的成本问题也不容忽视。ASML最新的High NA系统EXE:5000造价接近4亿美元,几乎是低数值孔径系统的两倍。IBM的成本分析显示,单次High NA曝光的成本大约是单次Low NA曝光的2.5倍,表明除非将三个Low NA掩模版缩减为一个High NA掩模版,否则High NA的单次曝光成本优势不会显现。此外,英特尔呼吁采用更大的6 x 12英寸掩模版,以提高生产效率并降低成本,但这一技术的实现仍需ASML的进一步开发。
展望未来,ASML正在研究超高数值孔径(Hyper-NA)EUV光刻技术的可行性,预计将在2030年左右实现。Hyper-NA的引入将取决于其成本是否合理,ASML必须回答这一技术是否具有经济可行性。目前,只有英特尔、三星和台积电等少数领先的芯片制造商可能成为Hyper-NA的潜在用户。
总体而言,High NA EUV技术在光刻性能、良率和成本方面展现出显著优势,但其广泛应用仍需克服技术和经济上的挑战。随着技术的进一步发展,High NA EUV有望在未来的半导体制造中发挥更加重要的作用。
原文和模型
【原文链接】 阅读原文 [ 6272字 | 26分钟 ]
【原文作者】 半导体行业观察
【摘要模型】 deepseek-v3
【摘要评分】 ★★★★★





